SiC MOSFET(1200V): 東芝デバイス&ストレージ製 (TW060N120C) 短絡耐量評価・解析レポート
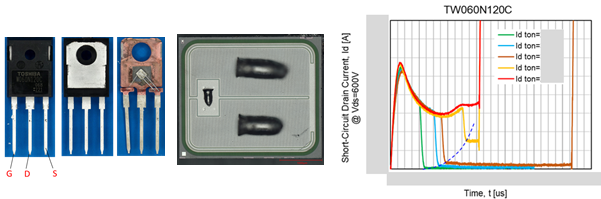
概要
パワートランジスタ、特にSiCパワーMOSFETの短絡(SC)耐量は、最も厳しい信頼性関連仕様の1つです。 SiベースのIGBTと比較して、SiCトランジスタのサイズは小さいため、SC耐久時間(tsc)が大幅に短くなります。
レポート概要
東芝の新しい(第 3 世代)1200V SiC MOSFETには、電流伝導とPウェルボディダイオードの劣化を排除するショットキーバリアダイオード(SBD)が搭載されており、さらにSBDはより低い逆伝導損失を実現できます。それにもかかわらず、MOSFET + SBDデバイスの短絡耐量データは報告されていません。
本レポートは、短絡データを提供し、このトランジスタの短絡耐量におけるSBDの影響を示す世界初のレポートになります。
本レポートの目的、着目点として
・試験測定データの結果と、これらの最先端SiCトランジスタの短絡耐量を制限する物理的メカニズムを特定するための解析評価。 破壊までの臨界温度(Tj,crit)および破壊エネルギー(Esc)が抽出されます。
・ゲート酸化膜が劣化し始める臨界温度も考慮されます。
・TOSHIBAと他社の1200V SiC MOSFETの短絡耐量の比較。トランジスタの構造比較。
・電気的特性(オフリーク電流と温度依存性)を比較し、相違点および制限を特定。
・この東芝第 3 世代トランジスタは、面積あたりのオン抵抗 (RonxA) を 40% 削減するだけでなく、Esc/A=115mJ/mm2 の SC 耐量エネルギーを保持する。
評価結果の重要性と使用法
・短絡保護回路の最小応答時間を推測することができます。
・測定された短絡ドレイン電流波形と耐久時間(tsc,f)を、SPICE電気・熱シミュレーションで
使用し、トランジスタの内部温度を推定することが可能です。
レポート価格
価格60万円(税別) 発注後1weekで納品
レポートパンフレット
SiC MOSFET(1200V): 東芝デバイス&ストレージ製短絡耐量評価・解析レポート (TW060N120C)
・その他当社リリースレポートは こちら










